めっきのひろば > UBMとは?
UBMとは?
はじめに
UBM(Under Bump Metal)は、半導体デバイスにおいて、電極パッドと基板間を接続するために使用される金属層です。UBMは、はんだ接合性を向上させ、酸化や剥離を防ぎ、接続部分の信頼性を高めます。これにより、デバイスは高温や振動などの過酷な条件にも耐えられるようになります。
当記事では、UBMの重要性を説明するとともに、UBMを形成するために必要な—電解めっき、無電解めっき、真空蒸着、スパッタリング、化学蒸着(CVD)などの技術について解説します。

1.UBMとは?
UBMとは、 「Under Bump Metal」または「Under Barrier Metal」の略で、半導体チップの電極パッド上に形成される金属層を指します。主な役割は、電極パッドとはんだバンプ(接続端子)との密着性や接合信頼性を高めることです。UBMは、はんだとアルミニウム電極の間に発生する拡散反応や剥離を防ぎ、電気的・機械的な安定性を確保します。材料としてはニッケル、銅、パラジウム、金などが多く用いられ、用途やプロセス条件に応じて多層構造で形成されます。
形成方法にはウェットめっきとドライめっきがあり、コストや膜厚精度、密着性の要求に応じて選定されます。UBMはフリップチップ実装など微細接合技術に不可欠なプロセスであり、ワイヤボンディング下地の強化用途では「OPM(Over Pad Metal)」や「FSM(Front Side Metal)」とも呼ばれています。
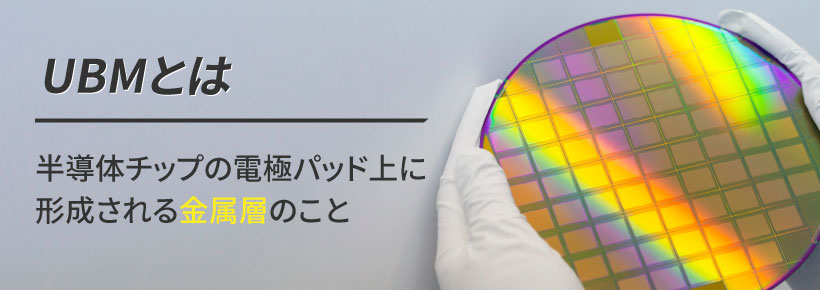
2.半導体にUBMを施す目的とは?
UBM(Under Bump Metal)は、半導体デバイスにおける電極と基板の接合を強化するために使われるめっき技術です。UBMを施す主な目的は以下の通りです。
■はんだ接合性の向上
UBMは、半導体チップの電極パッドとはんだとの接続を強化します。特に、はんだを使って部品を接続する際に、はんだの流れが均一になり、接合部分が強固になります。これにより、デバイスが高温や振動などの過酷な条件でも、接続部分が剥がれにくくなるため、長期間の使用に耐えることができます。
■酸化防止と耐久性の向上
UBMの金属層は、電極パッドが酸化するのを防ぎ、耐食性を向上させます。半導体は非常に微細で、酸化や腐食が起こると性能が低下するため、UBMによってこれらのリスクを軽減し、デバイスの寿命を延ばすことができます。
■接合強度の向上
UBMは、電極と基板を接続する際の強度を高めます。半導体デバイスの内部では、さまざまな力が加わるため、強固な接合が必要です。UBMは、その接続部分を強化し、デバイス全体の信頼性を高めます。
■熱的および機械的負荷への耐性
UBMを使用することで、熱や機械的な負荷に対する耐性も向上します。はんだの接合部分が熱膨張に対応できるようになり、温度変化による亀裂や剥がれを防ぐ役割を果たします。

3.UBMの形成方法
UBMの形成方法には電解めっき(電気めっき)、無電解めっき、真空蒸着、スパッタリング、化学蒸着(CVD)などさまざまな技術があります。ここでは、それぞれの方法の詳細について解説します。

1.電解めっき(電気めっき)
電解めっき(電気めっき)は、 外部電源を使用して金属を電極表面に析出させる方法です。UBM(Under Bump Metal)層の形成において、この方法は高い厚さを持つ層を強制的に作ることができ、特にバンプやピラーの形成に適しています。電解めっきでは、ウエハ表面に金属を均等に析出させるために、専用の治具を用いて外部電源を取り付け、電気を流します。このため、下地金属の形成やレジストパターンの準備が必要で、処理工程がやや複雑です。また、一度に処理できるウエハの枚数が限られるため、大量生産には向かない場合があります。
電解めっきのメリットとして、非常に微細な電極や配線へのめっきが可能で、無電解めっきよりも精密なパターン形成が得意です。デメリットとしては、膜厚にばらつきが出ることがあり、品質管理が必要です。全工程での処理時間が長くなるため、納期短縮やコスト削減の面で工夫が求められます。
2.無電解めっき
無電解めっきは、 外部電源を使用せず、金属のイオン化エネルギー差を利用して金属を析出させる方法です。この特徴により、下地金属がなくてもUBM層を形成できます。さらに、選択的に金属露出部分のみを処理でき、レジストパターンを使わずに効率的な処理が可能です。複数枚のウエハを同時に処理できるため、大量生産にも向いており、納期短縮にも貢献します。
ただし、無電解めっきでは形成できる金属の種類が限られており、通常は数μmの薄い層が最も効率的に形成されます。厚い層を作ると、処理時間が長くなり効率が低下します。さらに、めっき液の管理が難しく、慎重な管理が求められます。無電解めっきは精密な膜厚分布を得られるため、大量生産に強みがありますが、膜厚の調整や金属の選択肢に制約がある点は注意が必要です。
3.真空蒸着
真空蒸着は、真空状態でUBM層を形成する方法です。真空蒸着では、金属や金属酸化物を加熱して蒸発させ、その蒸気がウエハ表面に堆積してUBM層を作ります。真空環境で行うため、材料の蒸気圧を低く保って効率的に金属を気化でき、高純度の薄膜を短時間で形成できます。
真空蒸着の特徴は、成膜速度が速く、金属や有機物など幅広い材料でUBM層を形成できる点です。装置も比較的簡単で、さまざまな材料を蒸着できます。しかし、成膜時の付着力が熱エネルギーによるため、やや弱くなることがあります。また、ウエハの電極部以外にUBM層ができないよう、専用マスクを使って注意深く操作する必要があります。真空蒸着は高純度で均一な薄膜を得られるため、精密なUBM層が求められる半導体製造に広く利用されています。
4.スパッタリング
スパッタリングは、 真空環境でUBM層を形成する技術の1つです。この方法では、不活性ガス(主にアルゴンガス)を真空中に導入し、成膜材料(ターゲット)にマイナスの電圧をかけます。その結果、プラズマ化されたガスのイオンがターゲットに衝突し、成膜材料の粒子を叩き出します。この粒子がウエハ表面に付着し、UBM層を形成します。
スパッタリングの特徴として、成膜粒子のエネルギーが高いため、付着力が強く、膜質が緻密で強いことが挙げられます。また、膜厚や膜質の制御が高精度で行えるため、安定した成膜が可能です。さらに、スパッタリングは高融点金属や合金、化合物など、真空蒸着では難しい材料でも成膜できるため、広範囲な成膜材料に対応可能です。加えて、反応性ガスを導入することで、酸化物や窒化物の成膜も実現できます。スパッタリングは、特に高精度なUBM層を求められる半導体製造において非常に有用であり、その安定性と多様な材料対応能力が大きな利点です。
5.化学蒸着(CVD)
CVD(Chemical Vapor Deposition、化学気相成長)は、 ガス状の原料を加熱して化学反応を促進し、ウエハ表面にUBM層を形成する方法です。CVD技術では、熱や電力などを使ってガス状の物質を化学反応させ、ウエハ表面に薄膜を堆積させます。CVDは高真空環境を必要とせず、比較的簡単な装置で実施できるため、大量生産に向いています。
CVDの大きな特徴は、成膜材料が化学反応によってウエハ表面の凹凸に回り込むため、段差や曲面の部分にも均一にUBM層を形成できる点です。これにより、複雑な形状の部品にも適用可能です。また、成膜速度が速く、処理面積が大きいことから、効率的に多くのウエハを処理できます。しかし、真空蒸着やスパッタリングに比べてウエハとUBM層の密着性は劣ることがあります。
CVDは、さまざまな材料で高精度な成膜が可能であり、広範囲に利用されています。特に大量生産や均一な膜厚が求められる場面で強力な技術です。
まとめ
UBM(Under Bump Metal)は、半導体チップの電極パッドとはんだバンプの間に形成される金属層で、密着性や接合信頼性を高める役割を果たします。主な目的は、はんだ接合性の向上、酸化防止、接合強度の向上、熱的・機械的負荷への耐性強化です。
形成方法には電解めっき、無電解めっき、真空蒸着、スパッタリング、CVDなどがあり、それぞれ特徴が異なります。電解めっきは厚膜形成に適し、無電解めっきは大量生産に有利です。真空蒸着は高純度で成膜速度が速く、スパッタリングは付着力が強く高精度な制御が可能です。CVDは段差への均一成膜が得意で大量生産向きです。用途やコスト、精度要求に応じて最適な方法を選定することが重要です。
めっきに関するお問い合わせはこちら










